
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
চিপ উৎপাদনে SiGe: একটি পেশাদার সংবাদ প্রতিবেদন
সেমিকন্ডাক্টর পদার্থের বিবর্তন
আধুনিক সেমিকন্ডাক্টর প্রযুক্তির ক্ষেত্রে, ক্ষুদ্রকরণের দিকে নিরলস ড্রাইভ ঐতিহ্যগত সিলিকন-ভিত্তিক উপকরণগুলির সীমাকে ঠেলে দিয়েছে। উচ্চ কর্মক্ষমতা এবং কম বিদ্যুত খরচের চাহিদা মেটাতে, SiGe (সিলিকন জার্মেনিয়াম) তার অনন্য শারীরিক এবং বৈদ্যুতিক বৈশিষ্ট্যগুলির কারণে সেমিকন্ডাক্টর চিপ উত্পাদনে পছন্দের একটি যৌগিক উপাদান হিসাবে আবির্ভূত হয়েছে। এই নিবন্ধটি মধ্যে delvesএপিটাক্সি প্রক্রিয়াSiGe এর এবং এপিটাক্সিয়াল বৃদ্ধিতে এর ভূমিকা, স্ট্রেনড সিলিকন অ্যাপ্লিকেশন এবং গেট-অল-এরাউন্ড (GAA) কাঠামো।
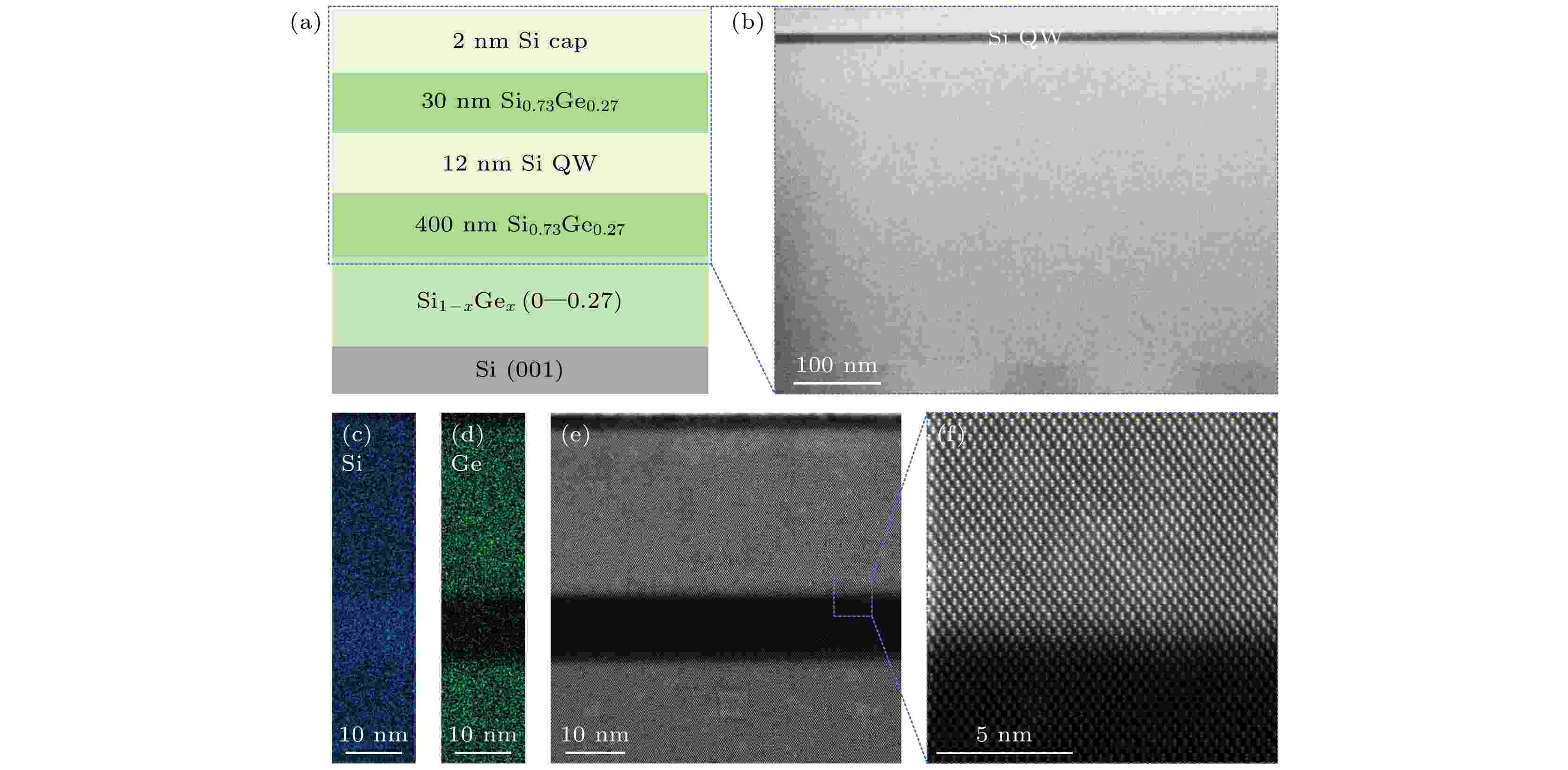
SiGe Epitaxy এর তাৎপর্য
1.1 চিপ উৎপাদনে এপিটাক্সির ভূমিকা:
Epitaxy, প্রায়শই Epi হিসাবে সংক্ষেপে, একই জালি বিন্যাস সহ একটি একক-স্ফটিক স্তরের উপর একটি একক-স্ফটিক স্তরের বৃদ্ধি বোঝায়। এই স্তরটিও হতে পারেহোমোপিটাক্সিয়াল (যেমন Si/Si)বা হেটেরোপিটাক্সিয়াল (যেমন SiGe/Si বা SiC/Si)। মলিকুলার বিম এপিটাক্সি (MBE), আল্ট্রা-হাই ভ্যাকুয়াম কেমিক্যাল ভ্যাপার ডিপোজিশন (UHV/CVD), বায়ুমণ্ডলীয় এবং হ্রাসকৃত চাপ এপিটাক্সি (ATM এবং RP Epi) সহ এপিটাক্সিয়াল বৃদ্ধির জন্য বিভিন্ন পদ্ধতি ব্যবহার করা হয়। এই নিবন্ধটি সিলিকন (Si) এবং সিলিকন-জার্মেনিয়াম (SiGe) এর এপিটাক্সি প্রক্রিয়াগুলির উপর আলোকপাত করে যা সেমিকন্ডাক্টর ইন্টিগ্রেটেড সার্কিট উত্পাদনে সিলিকনের সাথে সাবস্ট্রেট উপাদান হিসাবে ব্যাপকভাবে ব্যবহৃত হয়।
1.2 SiGe Epitaxy এর সুবিধা:
সময় জার্মেনিয়াম (Ge) একটি নির্দিষ্ট অনুপাত অন্তর্ভুক্তএপিটাক্সি প্রক্রিয়াএকটি SiGe একক-ক্রিস্টাল স্তর তৈরি করে যা শুধু ব্যান্ডগ্যাপের প্রস্থই কমায় না বরং ট্রানজিস্টরের কাট-অফ ফ্রিকোয়েন্সি (fT) বাড়ায়। এটি বেতার এবং অপটিক্যাল যোগাযোগের জন্য উচ্চ-ফ্রিকোয়েন্সি ডিভাইসগুলিতে এটি ব্যাপকভাবে প্রযোজ্য করে তোলে। অধিকন্তু, উন্নত CMOS ইন্টিগ্রেটেড সার্কিট প্রক্রিয়াগুলিতে, Ge এবং Si-এর মধ্যে জালির অমিল (প্রায় 4%) জালির চাপ প্রবর্তন করে, যা ইলেকট্রন বা গর্তের গতিশীলতা বাড়ায় এবং এইভাবে ডিভাইসের স্যাচুরেশন কারেন্ট এবং প্রতিক্রিয়া গতি বৃদ্ধি করে।
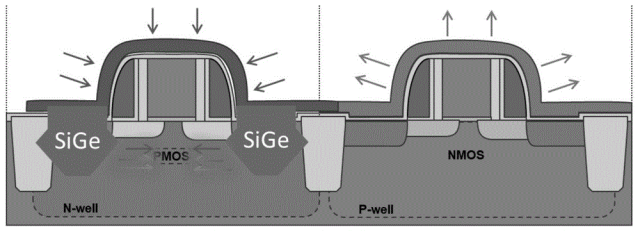
ব্যাপক SiGe এপিটাক্সি প্রসেস ফ্লো
2.1 প্রাক-চিকিৎসা:
সিলিকন ওয়েফারগুলি পছন্দসই প্রক্রিয়ার ফলাফলের উপর ভিত্তি করে প্রাক-চিকিত্সা করা হয়, প্রাথমিকভাবে ওয়েফার পৃষ্ঠের প্রাকৃতিক অক্সাইড স্তর এবং অমেধ্য অপসারণ জড়িত। ভারীভাবে ডোপড সাবস্ট্রেট ওয়েফারের জন্য, পরবর্তী সময়ে স্বয়ংক্রিয় ডোপিং কমাতে ব্যাকসিলিং প্রয়োজনীয় কিনা তা বিবেচনা করা গুরুত্বপূর্ণএপিটাক্সি বৃদ্ধি.
2.2 বৃদ্ধির গ্যাস এবং শর্তাবলী:
সিলিকন গ্যাস: সিলেন (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), এবং Trichlorosilane (TCS, SiHCl₃) হল তিনটি সর্বাধিক ব্যবহৃত সিলিকন গ্যাসের উৎস। SiH₄ কম-তাপমাত্রার পূর্ণ এপিটাক্সি প্রক্রিয়ার জন্য উপযুক্ত, অন্যদিকে TCS, তার দ্রুত বৃদ্ধির হারের জন্য পরিচিত, ব্যাপকভাবে ঘন তৈরির জন্য ব্যবহৃত হয়সিলিকন এপিটাক্সিস্তর
জার্মেনিয়াম গ্যাস: জার্মানি (GeH₄) হল জার্মেনিয়াম যোগ করার প্রাথমিক উৎস, সিজি অ্যালয় তৈরি করতে সিলিকন উত্সের সাথে একত্রে ব্যবহৃত হয়।
সিলেক্টিভ এপিটাক্সি: সিলেক্টিভ গ্রোথ এর আপেক্ষিক হার সামঞ্জস্য করে অর্জন করা হয়এপিটাক্সিয়াল জমাএবং সিটু এচিং-এ, ক্লোরিনযুক্ত সিলিকন গ্যাস DCS ব্যবহার করে। সিলিকন পৃষ্ঠের Cl পরমাণুর শোষণ অক্সাইড বা নাইট্রাইডের চেয়ে কম হওয়ায় এপিটাক্সিয়াল বৃদ্ধির সুবিধার কারণে সিলেক্টিভিটি হয়। SiH₄, Cl পরমাণুর অভাব এবং কম সক্রিয়করণ শক্তি সহ, সাধারণত শুধুমাত্র নিম্ন-তাপমাত্রার সম্পূর্ণ এপিটাক্সি প্রক্রিয়াগুলিতে প্রয়োগ করা হয়। আরেকটি সাধারণভাবে ব্যবহৃত সিলিকন উৎস, TCS-এর কম বাষ্পের চাপ থাকে এবং এটি ঘরের তাপমাত্রায় তরল থাকে, এটিকে প্রতিক্রিয়া চেম্বারে প্রবর্তনের জন্য H₂ বুদবুদ প্রয়োজন। যাইহোক, এটি তুলনামূলকভাবে সস্তা এবং প্রায়শই এটির দ্রুত বৃদ্ধির হার (5 μm/মিনিট পর্যন্ত) ঘন সিলিকন এপিটাক্সি স্তর বৃদ্ধির জন্য ব্যবহৃত হয়, সিলিকন এপিটাক্সি ওয়েফার উৎপাদনে ব্যাপকভাবে প্রয়োগ করা হয়।
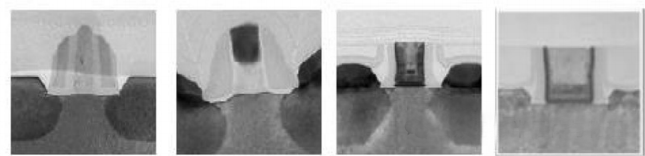
এপিটাক্সিয়াল লেয়ারে স্ট্রেনড সিলিকন
সময়এপিটাক্সিয়াল বৃদ্ধি, এপিটাক্সিয়াল একক-ক্রিস্টাল Si একটি শিথিল SiGe স্তরে জমা হয়। Si এবং SiGe-এর মধ্যে জালির অমিলের কারণে, Si একক-ক্রিস্টাল স্তরটি অন্তর্নিহিত SiGe স্তর থেকে প্রসার্য চাপের শিকার হয়, যা NMOS ট্রানজিস্টরগুলিতে ইলেক্ট্রন গতিশীলতাকে উল্লেখযোগ্যভাবে বৃদ্ধি করে। এই প্রযুক্তি শুধুমাত্র স্যাচুরেশন কারেন্ট (Idsat) বাড়ায় না বরং ডিভাইসের প্রতিক্রিয়ার গতিও উন্নত করে। পিএমওএস ডিভাইসের জন্য, চ্যানেলে সংকোচনমূলক চাপ প্রবর্তন করার জন্য, গর্তের গতিশীলতা বৃদ্ধি করে এবং স্যাচুরেশন কারেন্ট বাড়াতে এচিং করার পরে SiGe স্তরগুলি উত্স এবং ড্রেন অঞ্চলে এপিটাক্সিলিভাবে বৃদ্ধি পায়।
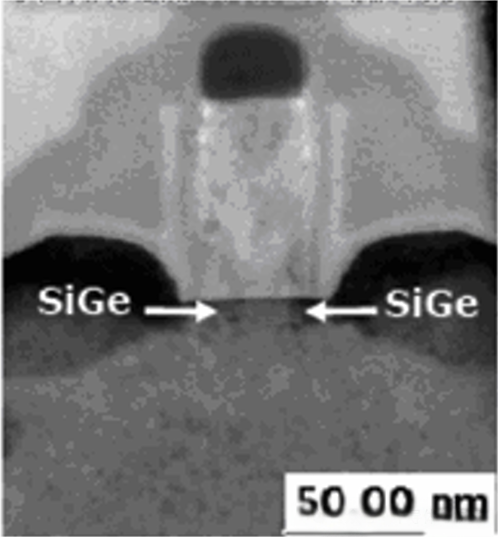
GAA স্ট্রাকচারে একটি বলির স্তর হিসাবে SiGe
গেট-অল-অ্যারাউন্ড (GAA) ন্যানোয়ার ট্রানজিস্টর তৈরিতে, SiGe স্তরগুলি বলির স্তর হিসাবে কাজ করে। হাই-সিলেক্টিভিটি অ্যানিসোট্রপিক এচিং কৌশল, যেমন কোয়াসি-অ্যাটমিক লেয়ার এচিং (কোয়াসি-এএলই), ন্যানোয়ার বা ন্যানোশিট স্ট্রাকচার গঠনের জন্য SiGe স্তরগুলিকে সুনির্দিষ্ট অপসারণের অনুমতি দেয়।
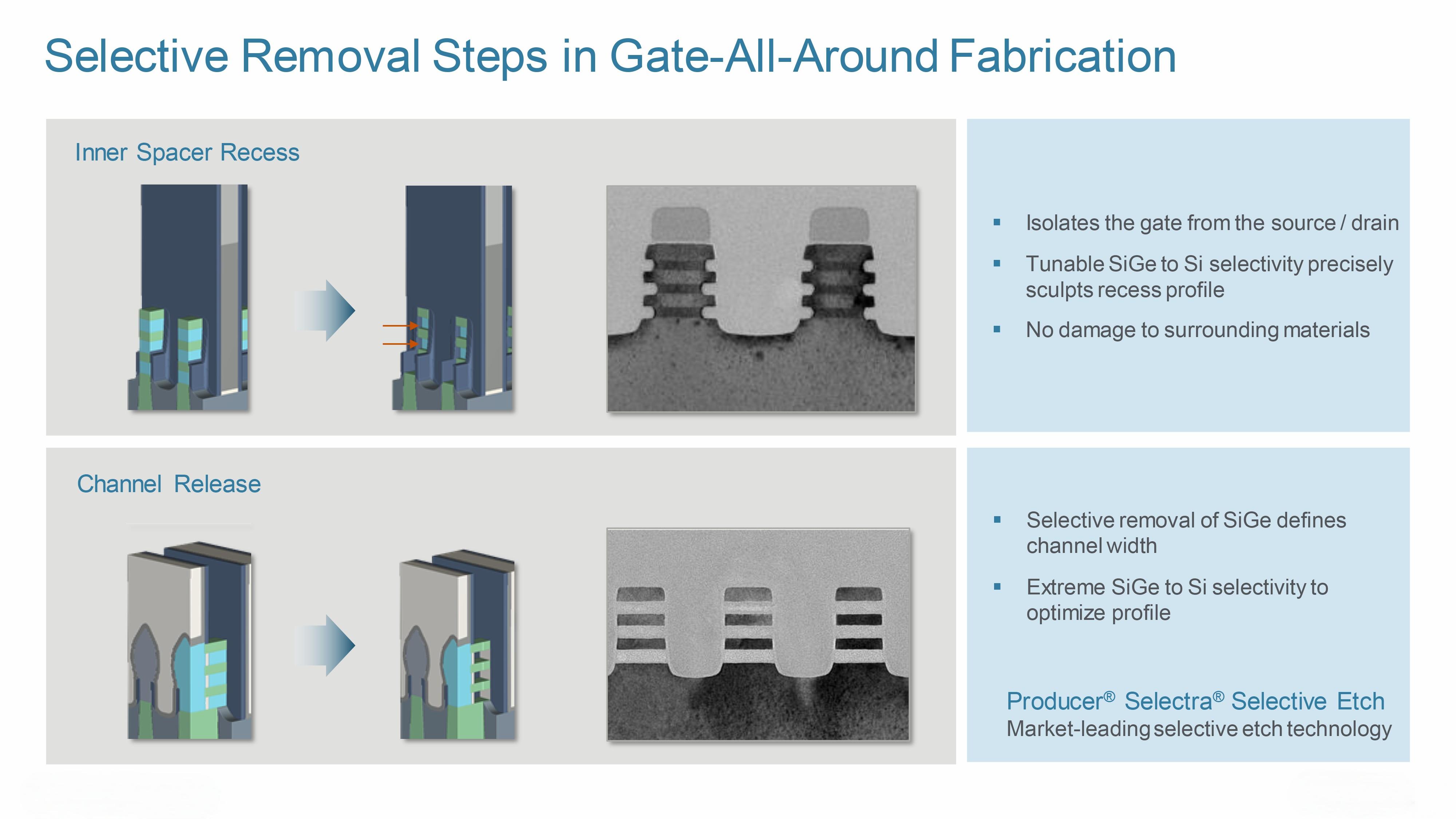
সেমিকোরেক্স-এ আমরা বিশেষজ্ঞSiC/TaC প্রলিপ্ত গ্রাফাইট সমাধানসেমিকন্ডাক্টর ম্যানুফ্যাকচারিং এ সি এপিটাক্সিয়াল বৃদ্ধিতে প্রয়োগ করা হয়েছে, যদি আপনার কোন জিজ্ঞাসা থাকে বা অতিরিক্ত বিবরণের প্রয়োজন হয়, দয়া করে আমাদের সাথে যোগাযোগ করতে দ্বিধা করবেন না।
যোগাযোগের ফোন: +86-13567891907
ইমেইল: sales@semicorex.com




